三星公布新 2.5D 封装技术,电气工程专家认为仍存缺陷
 35
35
 拍明
拍明
原标题:三星公布新 2.5D 封装技术,电气工程专家认为仍存缺陷
三星确实公布了其新的2.5D封装技术,并引起了电气工程专家们的关注。以下是对这一技术及其存在缺陷的详细分析:
一、三星新2.5D封装技术概述
三星的下一代2.5D封装技术名为I-Cube4,该技术提升了逻辑器件和内存之间的通信效率,并集成了1颗逻辑芯片和4颗高带宽内存(HBM)。I-Cube4在保持性能的前提下,将中介层(Interposer)做得比纸还薄,厚度仅有100μm,从而节省了芯片空间。
此外,I-Cube4的2.5D封装技术降低了空间占用和功率损耗,加强了产品的热管理,并提升了产品性能。三星还针对I-Cube4开发了无模具架构(mold-free structure),通过预筛选测试在制造过程中找出缺陷产品,从而有效地提升成品率。这一技术可以应用于高性能计算、AI、5G、云等多种领域。
二、电气工程专家对I-Cube4技术的评价
尽管I-Cube4技术具有诸多优势,但电气工程专家们也指出了其存在的缺陷:
寄生参数问题:为了获得高计算性能,I-Cube4需要HBM尽可能地接近逻辑芯片,这造成了寄生参数的出现。寄生参数一般出现在PCB板的设计中,主要产生的原因是电路板和器件自身引入的电阻、电容、电感等互相干扰。这一问题也会出现在晶圆层面上,这些寄生参数会影响产品的性能,使其无法达到设计数值。
中介层稳定性问题:I-Cube4的中介层厚度仅有100μm,虽然提升了产品性能,但过薄的中介层也容易出现弯曲或翘起等现象。尽管三星的研究人员通过选择合适的中介层材料与厚度解决了这一问题,但中介层的稳定性仍然是一个需要关注的问题。
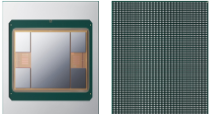
三、2.5D封装技术的发展与挑战
2.5D封装技术是一种先进的异构芯片封装技术,它结合了2D(平面)和3D(立体)封装的特点,实现了多个芯片的高密度线路连接并集成为一个封装。然而,这一技术也面临着诸多挑战:
布线尺寸减小带来的干扰:随着封装空间的不断压缩,布线尺寸的减小增加了互连线之间的干扰。这要求封装材料必须有效地考虑系统和芯片的影响,站在整个CPS(Chip+Package+System)的完整链条上去考虑封装材料参数的设计和优化。
热管理问题:多芯片的堆叠增加了热量集中的问题,必须对热进行合理的规划和管理。2.5D封装通过合理布局芯片位置和优化散热通道设计来解决这一问题,但热管理仍然是封装技术中的一个重要挑战。
应力开裂风险:多芯片的堆叠也增加了应力开裂的风险。这要求封装材料和工艺必须具有高可靠性和稳定性。
综上所述,三星的I-Cube4 2.5D封装技术虽然具有诸多优势,但也存在一些缺陷和挑战。未来,随着技术的不断发展,相信这些缺陷和挑战将会得到逐步解决和克服。
责任编辑:
【免责声明】
1、本文内容、数据、图表等来源于网络引用或其他公开资料,版权归属原作者、原发表出处。若版权所有方对本文的引用持有异议,请联系拍明芯城(marketing@iczoom.com),本方将及时处理。
2、本文的引用仅供读者交流学习使用,不涉及商业目的。
3、本文内容仅代表作者观点,拍明芯城不对内容的准确性、可靠性或完整性提供明示或暗示的保证。读者阅读本文后做出的决定或行为,是基于自主意愿和独立判断做出的,请读者明确相关结果。
4、如需转载本方拥有版权的文章,请联系拍明芯城(marketing@iczoom.com)注明“转载原因”。未经允许私自转载拍明芯城将保留追究其法律责任的权利。
拍明芯城拥有对此声明的最终解释权。




 产品分类
产品分类























 2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)
2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)


