MOSFET工作原理及其结构、特性
 665
665
 拍明
拍明
1.概述
MOSFET的原意是:MOS(Metal Oxide Semiconductor金属氧化物半导体),FET(Field Effect Transistor场效应晶体管),即以金属层(M)的栅极隔着氧化层(O)利用电场的效应来控制半导体(S)的场效应晶体管。
功率场效应晶体管也分为结型和绝缘栅型,但通常主要指绝缘栅型中的MOS型(Metal Oxide Semiconductor FET),简称功率MOSFET(Power MOSFET)。结型功率场效应晶体管一般称作静电感应晶体管(Static Induction Transistor——SIT)。其特点是用栅极电压来控制漏极电流,驱动电路简单,需要的驱动功率小,开关速度快,工作频率高,热稳定性优于GTR, 但其电流容量小,耐压低,一般只适用于功率不超过10kW的电力电子装置。
2.功率MOSFET的结构和工作原理
功率MOSFET的种类:按导电沟道可分为P沟道和N沟道。按栅极电压幅值可分为;耗尽型;当栅极电压为零时漏源极之间就存在导电沟道,增强型;对于N(P)沟道器件,栅极电压大于(小于)零时才存在导电沟道,功率MOSFET主要是N沟道增强型。
2.1功率MOSFET的结构
功率MOSFET的内部结构和电气符号如图1所示;其导通时只有一种极性的载流子(多子)参与导电,是单极型晶体管。导电机理与小功率mos管相同,但 结构上有较大区别,小功率MOS管是横向导电器件,功率MOSFET大都采用垂直导电结构,又称为VMOSFET(Vertical MOSFET),大大提高了MOSFET器件的耐压和耐电流能力。
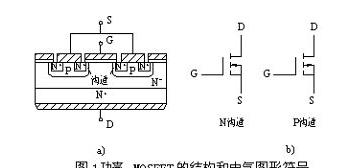
按垂直导电结构的差异,又分为利用V型槽实现垂直导电的VVMOSFET和具有垂直导电双扩散MOS结构的VDMOSFET(Vertical Double-diffused MOSFET),本文主要以VDMOS器件为例进行讨论。
功率MOSFET为多元集成结构,如国际整流器公司(International Rectifier)的HEXFET采用了六边形单元;西门子公司(Siemens)的SIPMOSFET采用了正方形单元;摩托罗拉公司 (Motorola)的TMOS采用了矩形单元按“品”字形排列。
2.2功率MOSFET的工作原理
截止:漏源极间加正电源,栅源极间电压为零。P基区与N漂移区之间形成的PN结J1反偏,漏源极之间无电流流过。
导电:在栅源极间加正电压UGS,栅极是绝缘的,所以不会有栅极电流流过。但栅极的正电压会将其下面P区中的空穴推开,而将P区中的少子—电子吸引到栅极下面的P区表面
当UGS大于UT(开启电压或阈值电压)时,栅极下P区表面的电子浓度将超过空穴浓度,使P型半导体反型成N型而成为反型层,该反型层形成N沟道而使PN结J1消失,漏极和源极导电。
2.3功率MOSFET的基本特性
2.3.1静态特性;其转移特性和输出特性如图2所示。
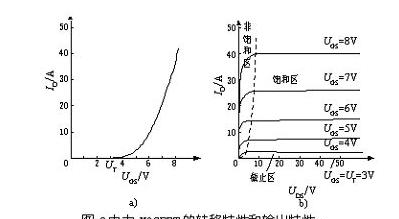
漏极电流ID和栅源间电压UGS的关系称为MOSFET的转移特性,ID较大时,ID与UGS的关系近似线性,曲线的斜率定义为跨导Gfs
MOSFET的漏极伏安特性(输出特性):截止区(对应于GTR的截止区);饱和区(对应于GTR的放大区);非饱和区(对应于GTR的饱和区)。电力 MOSFET工作在开关状态,即在截止区和非饱和区之间来回转换。电力MOSFET漏源极之间有寄生二极管,漏源极间加反向电压时器件导通。电力 MOSFET的通态电阻具有正温度系数,对器件并联时的均流有利。
2.3.2动态特性;其测试电路和开关过程波形如图3所示。

开通过程;开通延迟时间td(on) —up前沿时刻到uGS=UT并开始出现iD的时刻间的时间段;
上升时间tr— uGS从uT上升到MOSFET进入非饱和区的栅压UGSP的时间段;
iD稳态值由漏极电源电压UE和漏极负载电阻决定。UGSP的大小和iD的稳态值有关,UGS达到UGSP后,在up作用下继续升高直至达到稳态,但iD已不变。
开通时间ton—开通延迟时间与上升时间之和。
关断延迟时间td(off) —up下降到零起,Cin通过Rs和RG放电,uGS按指数曲线下降到UGSP时,iD开始减小为零的时间段。
下降时间tf— uGS从UGSP继续下降起,iD减小,到uGS
关断时间toff—关断延迟时间和下降时间之和。
2.3.3 MOSFET的开关速度。
MOSFET的开关速度和Cin充放电有很大关系,使用者无法降低Cin, 但可降低驱动电路内阻Rs减小时间常数,加快开关速度,MOSFET只靠多子导电,不存在少子储存效应,因而关断过程非常迅速,开关时间在10— 100ns之间,工作频率可达100kHz以上,是主要电力电子器件中最高的。
场控器件静态时几乎不需输入电流。但在开关过程中需对输入电容充放电,仍需一定的驱动功率。开关频率越高,所需要的驱动功率越大。
2.4动态性能的改进
在器件应用时除了要考虑器件的电压、电流、频率外,还必须掌握在应用中如何保护器件,不使器件在瞬态变化中受损害。当然晶闸管是两个双极型晶体管的组 合,又加上因大面积带来的大电容,所以其dv/dt能力是较为脆弱的。对di/dt来说,它还存在一个导通区的扩展问题,所以也带来相当严格的限制。
功率MOSFET的情况有很大的不同。它的dv/dt及di/dt的能力常以每纳秒(而不是每微秒)的能力来估量。但尽管如此,它也存在动态性能的限制。这些我们可以从功率MOSFET的基本结构来予以理解。
图4是功率MOSFET的结构和其相应的等效电路。除了器件的几乎每一部分存在电容以外,还必须考虑MOSFET还并联着一个二极管。同时从某个角度 看、它还存在一个寄生晶体管。(就像IGBT也寄生着一个晶闸管一样)。这几个方面,是研究MOSFET动态特性很重要的因素。
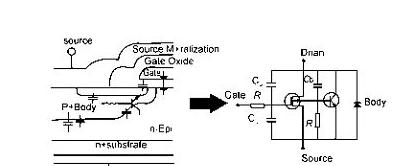
首先MOSFET结构中所附带的本征二极管具有一定的雪崩能力。通常用单次雪崩能力和重复雪崩能力来表达。当反向di/dt很大时,二极管会承受一个速 度非常快的脉冲尖刺,它有可能进入雪崩区,一旦超越其雪崩能力就有可能将器件损坏。作为任一种PN结二极管来说,仔细研究其动态特性是相当复杂的。它们和 我们一般理解PN结正向时导通反向时阻断的简单概念很不相同。当电流迅速下降时,二极管有一阶段失去反向阻断能力,即所谓反向恢复时间。PN结要求迅速导 通时,也会有一段时间并不显示很低的电阻。在功率MOSFET中一旦二极管有正向注入,所注入的少数载流子也会增加作为多子器件的MOSFET的复杂性。
功率MOSFET的设计过程中采取措施使其中的寄生晶体管尽量不起作用。在不同代功率MOSFET中其 措施各有不同,但总的原则是使漏极下的横向电阻RB尽量小。因为只有在漏极N区下的横向电阻流过足够电流为这个N区建立正偏的条件时,寄生的双极性晶闸管 才开始发难。然而在严峻的动态条件下,因dv/dt通过相应电容引起的横向电流有可能足够大。此时这个寄生的双极性晶体管就会起动,有可能给MOSFET 带来损坏。所以考虑瞬态性能时对功率MOSFET器件内部的各个电容(它是dv/dt的通道)都必须予以注意。
瞬态情况是和线路情况密切相关的,这方面在应用中应给予足够重视。对器件要有深入了解,才能有利于理解和分析相应的问题。
3.高压MOSFET原理与性能分析
在功率半导体器件中,MOSFET以高速、低开关损耗、低驱动损耗在各种功率变换,特别是高频功率变换中起着重要作用。在低压领域,MOSFET没有竞 争对手,但随着MOS的耐压提高,导通电阻随之以2.4-2.6次方增长,其增长速度使MOSFET制造者和应用者不得不以数十倍的幅度降低额定电流,以 折中额定电流、导通电阻和成本之间的矛盾。即便如此,高压MOSFET在额定结温下的导通电阻产生的导通压降仍居高不下,耐压500V以上的MOSFET 的额定结温、额定电流条件下的导通电压很高,耐压800V以上的导通电压高得惊人,导通损耗占MOSFET总损耗的2/3-4/5,使应用受到极大限制。
3.1降低高压MOSFET导通电阻的原理与方法
3.1.1 不同耐压的MOSFET的导通电阻分布。
不同耐压的MOSFET,其导通电阻中各部分电阻比例分布也不同。如耐压30V的MOSFET,其外延层电阻仅为 总导通电阻的29%,耐压600V的MOSFET的外延层电阻则是总导通电阻的96.5%。由此可以推断耐压800V的MOSFET的导通电阻将几乎被外 延层电阻占据。欲获得高阻断电压,就必须采用高电阻率的外延层,并增厚。这就是常规高压MOSFET结构所导致的高导通电阻的根本原因。
3.1.2 降低高压MOSFET导通电阻的思路。
增加管芯面积虽能降低导通电阻,但成本的提高所付出的代价是商业品所不允许的。引入少数载流子导电虽能降低导通压降,但付出的代价是开关速度的降低并出现拖尾电流,开关损耗增加,失去了MOSFET的高速的优点。
以上两种办法不能降低高压MOSFET的导通电阻,所剩的思路就是如何将阻断高电压的低掺杂、高电阻率区域和导电通道的高掺杂、低电阻率分开解决。如除 导通时低掺杂的高耐压外延层对导通电阻只能起增大作用外并无其他用途。这样,是否可以将导电通道以高掺杂较低电阻率实现,而在MOSFET关断时,设法使 这个通道以某种方式夹断,使整个器件耐压仅取决于低掺杂的N-外延层。基于这种思想,1988年INFINEON推出内建横向电场耐压为600V的 COOLMOS,使这一想法得以实现。内建横向电场的高压MOSFET的剖面结构及高阻断电压低导通电阻的示意图如图5所示。
与常规MOSFET结构不同,内建横向电场的MOSFET嵌入垂直P区将垂直导电区域的N区夹在中间,使MOSFET关断时,垂直的P与N之间建立横向电场,并且垂直导电区域的N掺杂浓度高于其外延区N-的掺杂浓度。
当VGS<VTH时,由于被电场反型而产生的N型导电沟道不能形成,并且D,S间加正电压,使MOSFET内部PN结反偏形成耗尽层,并将垂直导电的N 区耗尽。这个耗尽层具有纵向高阻断电压,如图5(b)所示,这时器件的耐压取决于P与N-的耐压。因此N-的低掺杂、高电阻率是必需的。

当CGS>VTH时,被电场反型而产生的N型导电沟道形成。源极区的电子通过导电沟道进入被耗尽的垂直的N区中和正电荷,从而恢复被耗尽的N型特性,因此导电沟道形成。由于垂直N区具有较低的电阻率,因而导通电阻较常规MOSFET将明显降低。
通过以上分析可以看到:阻断电压与导通电阻分别在不同的功能区域。将阻断电压与导通电阻功能分开,解决了阻断电压与导通电阻的矛盾,同时也将阻断时的表面PN结转化为掩埋PN结,在相同的N-掺杂浓度时,阻断电压还可进一步提高。
3.2内建横向电场MOSFET的主要特性
3.2.1 导通电阻的降低。
INFINEON的内建横向电场的MOSFET,耐压600V和800V,与常规MOSFET器件相比,相同的管芯面积,导通电阻分别下 降到常规MOSFET的1/5, 1/10;相同的额定电流,导通电阻分别下降到1/2和约1/3。在额定结温、额定电流条件下,导通电压分别从12.6V,19.1V下降到 6.07V,7.5V;导通损耗下降到常规MOSFET的1/2和1/3。由于导通损耗的降低,发热减少,器件相对较凉,故称COOLMOS。
3.2.2 封装的减小和热阻的降低。
相同额定电流的COOLMOS的管芯较常规MOSFET减小到1/3和1/4,使封装减小两个管壳规格。
由于COOLMOS管芯厚度仅为常规MOSFET的1/3,使TO-220封装RTHJC从常规1℃/W降到0.6℃/W;额定功率从125W上升到208W,使管芯散热能力提高。
.2.3 开关特性的改善。
COOLMOS的栅极电荷与开关参数均优于常规MOSFET,很明显,由于QG,特别是QGD的减少,使COOLMOS的开关时间约为常 规MOSFET的1/2;开关损耗降低约50%。关断时间的下降也与COOLMOS内部低栅极电阻(<1Ω=有关。
3.2.4 抗雪崩击穿能力与SCSOA。
目前,新型的MOSFET无一例外地具有抗雪崩击穿能力。COOLMOS同样具有抗雪崩能力。在相同额定电流 下,COOLMOS的IAS与ID25℃相同。但由于管芯面积的减小,IAS小于常规MOSFET,而具有相同管芯面积时,IAS和EAS则均大于常规 MOSFET。
COOLMOS的最大特点之一就是它具有短路安全工作区(SCSOA),而常规MOS不具备这个特性。 COOLMOS的SCSOA的获得主要是由于转移特性的变化和管芯热阻降低。COOLMOS的转移特性如图6所示。从图6可以看到,当VGS>8V 时,COOLMOS的漏极电流不再增加,呈恒流状态。特别是在结温升高时,恒流值下降,在最高结温时,约为ID25℃的2倍,即正常工作电流的3-3.5 倍。在短路状态下,漏极电流不会因栅极的15V驱动电压而上升到不可容忍的十几倍的ID25℃,使COOLMOS在短路时所耗散的功率限制在 350V×2ID25℃,尽可能地减少短路时管芯发热。管芯热阻降低可使管芯产生的热量迅速地散发到管壳,抑制了管芯温度的上升速度。因 此,COOLMOS可在正常栅极电压驱动,在0.6VDSS电源电压下承受10ΜS短路冲击,时间间隔大于1S,1000次不损坏,使COOLMOS可像 IGBT一样,在短路时得到有效的保护。
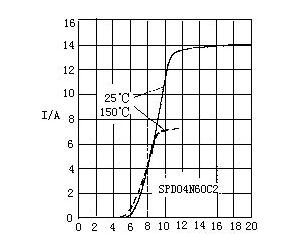
3.3关于内建横向电场高压MOSFET发展现状
继INFINEON1988年推出COOLMOS后,2000年初ST推出500V类似于COOLMOS的内部结构,使500V,12A的MOSFET 可封装在TO-220管壳内,导通电阻为0.35Ω,低于IRFP450的0.4Ω,电流额定值与IRFP450相近。IXYS也有使用COOLMOS技 术的MOSFET。IR公司也推出了SUPPER220,SUPPER247封装的超级MOSFET,额定电流分别为35A,59A,导通电阻分别为 0.082Ω,0.045Ω,150℃时导通压降约4.7V。从综合指标看,这些MOSFET均优于常规MOSFET,并不是因为随管芯面积增加,导通电 阻就成比例地下降,因此,可以认为,以上的MOSFET一定存在类似横向电场的特殊结构,可以看到,设法降低高压MOSFET的导通压降已经成为现实,并 且必将推动高压MOSFET的应用。
3.4 COOLMOS与IGBT的比较
600V、800V耐压的 COOLMOS的高温导通压降分别约6V,7.5V,关断损耗降低1/2,总损耗降低1/2以上,使总损耗为常规MOSFET的40%-50%。常规 600V耐压MOSFET导通损耗占总损耗约75%,对应相同总损耗超高速IGBT的平衡点达160KHZ,其中开关损耗占约75%。由于COOLMOS 的总损耗降到常规MOSFET的40%-50%,对应的IGBT损耗平衡频率将由160KHZ降到约40KHZ,增加了MOSFET在高压中的应用。
从以上讨论可见,新型高压MOSFET使长期困扰高压MOSFET的导通压降高的问题得到解决;可简化整机设计,如散热器件体积可减少到原40%左右;驱动电路、缓冲电路简化;具备抗雪崩击穿能力和抗短路能力;简化保护电路并使整机可靠性得以提高。
4.功率MOSFET驱动电路
功率MOSFET是电压型驱动器件,没有少数载流子的存贮效应,输入阻抗高,因而开关速度可以很高,驱动功率小,电路简单。但功率MOSFET的极间电容较大,输入电容CISS、输出电容COSS和反馈电容CRSS与极间电容的关系可表述为:
功率MOSFET的栅极输入端相当于一个容性网络,它的工作速度与驱动源内阻抗有关。由于 CISS的存在,静态时栅极驱动电流几乎为零,但在开通和关断动态过程中,仍需要一定的驱动电流。假定开关管饱和导通需要的栅极电压值为VGS,开关管的 开通时间TON包括开通延迟时间TD和上升时间TR两部分。
开关管关断过程中,CISS通过ROFF放电,COSS由RL充电,COSS较大,VDS(T)上升较慢,随着VDS(T)上升较慢,随着VDS(T)的升高COSS迅速减小至接近于零时,VDS(T)再迅速上升。
根据以上对功率MOSFET特性的分析,其驱动通常要求:触发脉冲要具有足够快的上升和下降速度;②开通时以低电阻力栅极电容充电,关断时为栅极提供低 电阻放电回路,以提高功率MOSFET的开关速度;③为了使功率MOSFET可靠触发导通,触发脉冲电压应高于管子的开启电压,为了防止误导通,在其截止 时应提供负的栅源电压;④功率开关管开关时所需驱动电流为栅极电容的充放电电流,功率管极间电容越大,所需电流越大,即带负载能力越大。
4.1几种MOSFET驱动电路介绍及分析
4.1.1不隔离的互补驱动电路。
图7(a)为常用的小功率驱动电路,简单可靠成本低。适用于不要求隔离的小功率开关设备。图7(b)所示驱动电路开关 速度很快,驱动能力强,为防止两个MOSFET管直通,通常串接一个0.5~1Ω小电阻用于限流,该电路适用于不要求隔离的中功率开关设备。这两种电路特 点是结构简单。
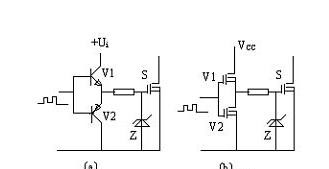
功率MOSFET属于电压型控制器件,只要栅极和源极之间施加的电压超过其阀值电压就会导通。由于MOSFET存在结电容,关断时其漏源两端电压的突然 上升将会通过结电容在栅源两端产生干扰电压。常用的互补驱动电路的关断回路阻抗小,关断速度较快,但它不能提供负压,故抗干扰性较差。为了提高电路的抗干 扰性,可在此种驱动电路的基础上增加一级有V1、V2、R组成的电路,产生一个负压,电路原理图如图8所示。

当V1导通时,V2关断,两个MOSFET中的上管的栅、源极放电,下管的栅、源极充电,即上管关断,下管导通,则被驱动的功率管关断;反之V1关断 时,V2导通,上管导通,下管关断,使驱动的管子导通。因为上下两个管子的栅、源极通过不同的回路充放电,包含有V2的回路,由于V2会不断退出饱和直至 关断,所以对于S1而言导通比关断要慢,对于S2而言导通比关断要快,所以两管发热程度也不完全一样,S1比S2发热严重。
该驱动电路的缺点是需要双电源,且由于R的取值不能过大,否则会使V1深度饱和,影响关断速度,所以R上会有一定的损耗。
4.1.2隔离的驱动电路
(1)正激式驱动电路。电路原理如图9(a)所示,N3为去磁绕组,S2为所驱动的功率管。R2为防止功率管栅极、源极端电压振荡的一个阻尼电阻。因不要求漏感较小,且从速度方面考虑,一般R2较小,故在分析中忽略不计。
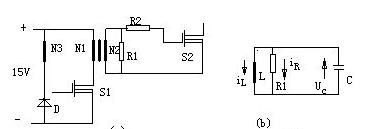
其等效电路图如图9(b)所示脉冲不要求的副边并联一电阻R1,它做为正激变换器的假负载,用于消除关断期间输出电压发生振荡而误导通。同时它还可 以作为功率MOSFET关断时的能量泄放回路。该驱动电路的导通速度主要与被驱动的S2栅极、源极等效输入电容的大小、S1的驱动信号的速度以及S1所能 提供的电流大小有关。由仿真及分析可知,占空比D越小、R1越大、L越大,磁化电流越小,U1值越小,关断速度越慢。该电路具有以下优点:
①电路结构简单可靠,实现了隔离驱动。
②只需单电源即可提供导通时的正、关断时负压。
③占空比固定时,通过合理的参数设计,此驱动电路也具有较快的开关速度。
该电路存在的缺点:一是由于隔离变压器副边需要噎嗝假负载防振荡,故电路损耗较大;二是当占空比变化时关断速度变化较大。脉宽较窄时,由于是储存的能量减少导致MOSFET栅极的关断速度变慢。
(2)有隔离变压器的互补驱动电路。如图10所示,V1、V2为互补工作,电容C起隔离直流的作用,T1为高频、高磁率的磁环或磁罐。
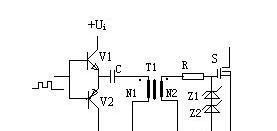
导通时隔离变压器上的电压为(1-D)Ui、关断时为D Ui,若主功率管S可靠导通电压为12V,而隔离变压器原副边匝比N1/N2为12/[(1-D)Ui]。为保证导通期间GS电压稳定C值可稍取大些。该电路具有以下优点:
①电路结构简单可靠,具有电气隔离作用。当脉宽变化时,驱动的关断能力不会随着变化。
②该电路只需一个电源,即为单电源工作。隔直电容C的作用可以在关断所驱动的管子时提供一个负压,从而加速了功率管的关断,且有较高的抗干扰能力。
但该电路存在的一个较大缺点是输出电压的幅值会随着占空比的变化而变化。当D较小时,负向电压小,该电路的抗干扰性变差,且正向电压较高,应该注意使其 幅值不超过MOSFET栅极的允许电压。当D大于0.5时驱动电压正向电压小于其负向电压,此时应该注意使其负电压值不超过MOAFET栅极允许电压。所 以该电路比较适用于占空比固定或占空比变化范围不大以及占空比小于0.5的场合。
(3)集成芯片UC3724/3725构成的驱动电路
电路构成如图11所示。其中UC3724用来产生高频载波信号,载波频率由电容CT和电阻RT决定。一般载波频率小于600kHz,4脚和6脚两端产生 高频调制波,经高频小磁环变压器隔离后送到UC3725芯片7、8两脚经UC3725进行调制后得到驱动信号,UC3725内部有一肖特基整流桥同时将 7、8脚的高频调制波整流成一直流电压供驱动所需功率。一般来说载波频率越高驱动延时越小,但太高抗干扰变差;隔离变压器磁化电感越大磁化电流越 小,UC3724发热越少,但太大使匝数增多导致寄生参数影响变大,同样会使抗干扰能力降低。根据实验数据得出:对于开关频率小于100kHz的信号一般 取(400~500)kHz载波频率较好,变压器选用较高磁导如5K、7K等高频环形磁芯,其原边磁化电感小于约1毫亨左右为好。这种驱动电路仅适合于信 号频率小于100kHz的场合,因信号频率相对载波频率太高的话,相对延时太多,且所需驱动功率增大,UC3724和UC3725芯片发热温升较高,故 100kHz以上开关频率仅对较小极电容的MOSFET才可以。对于1kVA左右开关频率小于100kHz的场合,它是一种良好的驱动电路。该电路具有以 下特点:单电源工作,控制信号与驱动实现隔离,结构简单尺寸较小,尤其适用于占空比变化不确定或信号频率也变化的场合。
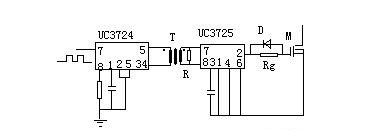
MOSFET工作原理
要使增强型N沟道MOSFET工作,要在G、S之间加正电压VGS及在D、S之间加正电压VDS,则产生正向工作电流ID。改变VGS的电压可控制工作电流ID。如图2所示。
若先不接VGS(即VGS=0),在D与S极之间加一正电压VDS,漏极D与衬底之间的PN结处于反向,因此漏源之间不能导电。如果在栅极G与源极S之间加一电压VGS。此时可以将栅极与衬底看作电容器的两个极板,而氧化物绝缘层作为电容器的介质。当加上VGS时,在绝缘层和栅极界面上感应出正电荷,而在绝缘层和P型衬底界面上感应出负电荷。这层感应的负电荷和P型衬底中的多数载流子(空穴)的极性相反,所以称为“反型层”,这反型层有可能将漏与源的两N型区连接起来形成导电沟道。当VGS电压太低时,感应出来的负电荷较少,它将被P型衬底中的空穴中和,因此在这种情况时,漏源之间仍然无电流ID。当VGS增加到一定值时,其感应的负电荷把两个分离的N区沟通形成N沟道,这个临界电压称为开启电压(或称阈值电压、门限电压),用符号VT表示(一般规定在ID=10uA时的VGS作为VT)。当VGS继续增大,负电荷增加,导电沟道扩大,电阻降低,ID也随之增加,并且呈较好线性关系,如图3所示。此曲线称为转换特性。因此在一定范围内可以认为,改变VGS来控制漏源之间的电阻,达到控制ID的作用。
由于这种结构在VGS=0时,ID=0,称这种MOSFET为增强型。另一类MOSFET,在VGS=0时也有一定的ID(称为IDSS),这种MOSFET称为耗尽型。它的结构如图4所示,它的转移特性如图5所示。VP为夹断电压(ID=0)。
耗尽型与增强型主要区别是在制造SiO2绝缘层中有大量的正离子,使在P型衬底的界面上感应出较多的负电荷,即在两个N型区中间的P型硅内形成一N型硅薄层而形成一导电沟道,所以在VGS=0时,有VDS作用时也有一定的ID(IDSS);当VGS有电压时(可以是正电压或负电压),改变感应的负电荷数量,从而改变ID的大小。VP为ID=0时的-VGS,称为夹断电压。
MOSFET主要参数
场效应管的参数很多,包括直流参数、交流参数和极限参数,但一般使用时关注以下主要参数:
1、IDSS—饱和漏源电流。是指结型或耗尽型绝缘栅场效应管中,栅极电压UGS=0时的漏源电流。
2、UP—夹断电压。是指结型或耗尽型绝缘栅场效应管中,使漏源间刚截止时的栅极电压。
3、UT—开启电压。是指增强型绝缘栅场效管中,使漏源间刚导通时的栅极电压。
4、gM—跨导。是表示栅源电压UGS—对漏极电流ID的控制能力,即漏极电流ID变化量与栅源电压UGS变化量的比值。gM是衡量场效应管放大能力的重要参数。
5、BUDS—漏源击穿电压。是指栅源电压UGS一定时,场效应管正常工作所能承受的最大漏源电压。这是一项极限参数,加在场效应管上的工作电压必须小于BUDS。
6、PDSM—最大耗散功率。也是一项极限参数,是指场效应管性能不变坏时所允许的最大漏源耗散功率。使用时,场效应管实际功耗应小于PDSM并留有一定余量。
7、IDSM—最大漏源电流。是一项极限参数,是指场效应管正常工作时,漏源间所允许通过的最大电流。场效应管的工作电流不应超过IDSM 。
MOSFET应用优势
1、场效应晶体管是电压控制元件,而双极结型晶体管是电流控制元件。在只允许从取较少电流的情况下,应选用场效应管;而在信号电压较低,又允许从信号源取较多电流的条件下,应选用双极晶体管。
2、有些场效应管的源极和漏极可以互换使用,栅压也可正可负,灵活性比双极晶体管好。
3、场效应管是利用多数载流子导电,所以称之为单极型器件,而双极结型晶体管是即有多数载流子,也利用少数载流子导电。因此被称之为双极型器件。
4、场效应管能在很小电流和很低电压的条件下工作,而且它的制造工艺可以很方便地把很多场效应管集成在一块硅片上,因此场效应管在大规模集成电路中得到了广泛的应用。
MOSFET在1960年由贝尔实验室(Bell Lab.)的D. Kahng和 Martin Atalla首次实作成功,这种元件的操作原理和1947年萧克莱(William Shockley)等人发明的双载流子结型晶体管(Bipolar Junction Transistor,BJT)截然不同,且因为制造成本低廉与使用面积较小、高整合度的优势,在大型集成电路(Large-Scale Integrated Circuits,LSI)或是超大型集成电路(Very Large-Scale Integrated Circuits,VLSI)的领域里,重要性远超过BJT。
由于MOSFET元件的性能逐渐提升,除了传统上应用于诸如微处理器、微控制器等数位信号处理的场合上,也有越来越多模拟信号处理的集成电路可以用MOSFET来实现,以下分别介绍这些应用。
数字电路
数字科技的进步,如微处理器运算效能不断提升,带给深入研发新一代MOSFET更多的动力,这也使得MOSFET本身的操作速度越来越快,几乎成为各种半导体主动元件中最快的一种。MOSFET在数字信号处理上最主要的成功来自CMOS逻辑电路的发明,这种结构最大的好处是理论上不会有静态的功率损耗,只有在逻辑门(logic gate)的切换动作时才有电流通过。CMOS逻辑门最基本的成员是CMOS反相器(inverter),而所有CMOS逻辑门的基本操作都如同反相器一样,在逻辑转换的瞬间同一时间内必定只有一种晶体管(NMOS或是PMOS)处在导通的状态下,另一种必定是截止状态,这使得从电源端到接地端不会有直接导通的路径,大量节省了电流或功率的消耗,也降低了集成电路的发热量。
MOSFET在数字电路上应用的另外一大优势是对直流(DC)信号而言,MOSFET的栅极端阻抗为无限大(等效于开路),也就是理论上不会有电流从MOSFET的栅极端流向电路里的接地点,而是完全由电压控制栅极的形式。这让MOSFET和他们最主要的竞争对手BJT相较之下更为省电,而且也更易于驱动。在CMOS逻辑电路里,除了负责驱动芯片外负载(off-chip load)的驱动器(driver)外,每一级的逻辑门都只要面对同样是MOSFET的栅极,如此一来较不需考虑逻辑门本身的驱动力。相较之下,BJT的逻辑电路(例如最常见的TTL)就没有这些优势。MOSFET的栅极输入电阻无限大对于电路设计工程师而言亦有其他优点,例如较不需考虑逻辑门输出端的负载效应(loading effect)。
模拟电路
有一段时间,MOSFET并非模拟电路设计工程师的首选,因为模拟电路设计重视的性能参数,如晶体管的转导(transconductance)或是电流的驱动力上,MOSFET不如BJT来得适合模拟电路的需求。但是随著MOSFET技术的不断演进,今日的CMOS技术也已经可以符合很多模拟电路的规格需求。再加上MOSFET因为结构的关系,没有BJT的一些致命缺点,如热破坏(thermal runaway)。另外,MOSFET在线性区的压控电阻特性亦可在集成电路里用来取代传统的多晶硅电阻(poly resistor),或是MOS电容本身可以用来取代常用的多晶硅—绝缘体—多晶硅电容(PIP capacitor),甚至在适当的电路控制下可以表现出电感(inductor)的特性,这些好处都是BJT很难提供的。也就是说,MOSFET除了扮演原本晶体管的角色外,也可以用来作为模拟电路中大量使用的被动元件(passive device)。这样的优点让采用MOSFET实现模拟电路不但可以满足规格上的需求,还可以有效缩小芯片的面积,降低生产成本。
随著半导体制造技术的进步,对于整合更多功能至单一芯片的需求也跟著大幅提升,此时用MOSFET设计模拟电路的另外一个优点也随之浮现。为了减少在印刷电路板(Printed Circuit Board,PCB)上使用的集成电路数量、减少封装成本与缩小系统的体积,很多原本独立的类比芯片与数位芯片被整合至同一个芯片内。MOSFET原本在数位集成电路上就有很大的竞争优势,在类比集成电路上也大量采用MOSFET之后,把这两种不同功能的电路整合起来的困难度也显著的下降。另外像是某些混合信号电路(Mixed-signal circuits),如类比/数位转换器(Analog-to-Digital Converter,ADC),也得以利用MOSFET技术设计出效能更好的产品。
还有一种整合MOSFET与BJT各自优点的制程技术:BiCMOS(Bipolar-CMOS)也越来越受欢迎。BJT元件在驱动大电流的能力上仍然比一般的CMOS优异,在可靠度方面也有一些优势,例如不容易被“静电放电”(ESD)破坏。所以很多同时需要复噪声号处理以及强大电流驱动能力的集成电路产品会使用BiCMOS技术来制作。
责任编辑:Davia
【免责声明】
1、本文内容、数据、图表等来源于网络引用或其他公开资料,版权归属原作者、原发表出处。若版权所有方对本文的引用持有异议,请联系拍明芯城(marketing@iczoom.com),本方将及时处理。
2、本文的引用仅供读者交流学习使用,不涉及商业目的。
3、本文内容仅代表作者观点,拍明芯城不对内容的准确性、可靠性或完整性提供明示或暗示的保证。读者阅读本文后做出的决定或行为,是基于自主意愿和独立判断做出的,请读者明确相关结果。
4、如需转载本方拥有版权的文章,请联系拍明芯城(marketing@iczoom.com)注明“转载原因”。未经允许私自转载拍明芯城将保留追究其法律责任的权利。
拍明芯城拥有对此声明的最终解释权。




 产品分类
产品分类















 2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)
2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)


