一种低功耗系统芯片的可测试性设计方案
 1
1
 拍明芯城
拍明芯城
低功耗系统芯片的可测试性设计方案详解
低功耗系统芯片(System on Chip, SoC)在现代电子产品中应用广泛,尤其在物联网、可穿戴设备、智能终端等领域,低功耗设计是核心竞争力。为了保证芯片在量产和研发阶段均具有高可靠性、可重复性和可维护性,必须构建完善的可测试性设计方案(Design for Testability, DFT)。本文将从可测试性设计总体方案展开,围绕关键测试接口、测试逻辑布置、测试资源配置、可观察性增强、可控性设计、测试数据采集与分析、自动测试方案(ATE)对接等方面展开详细论述,并优选可采购的元器件型号,讲述元器件功能及为何选择该器件。

为了便于读者结合采购、研发、量产设计等环节实现闭环,方案中列举具体元器件型号及其功能特性,推荐采购信息可通过拍明芯城 www.iczoom.com 查询元件参数、品牌、封装、供应商、价格参考、国产替代方案和PDF数据手册等资料。
一、低功耗系统芯片可测试性设计总体理念与目标
低功耗系统芯片的可测试性设计是指在芯片设计初期即融入测试思路,使芯片在制造测试、系统集成测试、现场维护测试等阶段都能方便获取内部状态、控制内部逻辑,并快速定位故障。可测试性设计须在保证芯片功能和功耗不受明显影响的条件下,实现以下核心目标:
一是增强芯片内部逻辑的可观测性(Observability),使测试设备能够读取内部触发器状态、总线状态、寄存器内容等;
二是增强芯片内部逻辑的可控性(Controllability),使测试设备能够驱动芯片内部节点、模拟特殊场景和电平;
三是支持生产测试自动化和故障模式覆盖率提升,结合内部自测逻辑和ATE(自动测试设备)对接,使测试时间缩短、测试成本降低、缺陷检测覆盖全面;
四是在低功耗模式下仍保留测试可执行性,避免诸多省电措施如时钟门控、休眠电路阻断测试路径;
五是为现场维护、在线自检、BIST(Built-In Self Test)提供基础,使芯片能在工作过程实现健康监测。
针对以上目标,低功耗SoC的可测试性设计方案从数字逻辑、存储单元、时钟管理、电源域、接口外设等多个维度建立策略。本方案以某典型低功耗SoC为例进行展开,元器件选择尽可能贴近市场主流,建议通过拍明芯城查询准确型号规格以确保参数匹配。
二、测试接口与测试逻辑布置
芯片外部的测试接口是ATE等测试系统与芯片内部逻辑通信的桥梁。常见标准包括JTAG(IEEE 1149.1)、IEEE 1149.7、SPI测试模式等。本方案建议在芯片设计中集成以下测试接口:
JTAG标准测试端口
推荐集成JTAG(Joint Test Action Group)标准端口,支持TCK、TMS、TDI、TDO等基本引脚。JTAG能够实现边界扫描(Boundary Scan)、内部寄存器访问、片上调试(On-Chip Debugging)等功能。边界扫描可以在不依赖芯片功能逻辑的情况下测试I/O引脚连通性。
元器件建议采用低功耗逻辑门和缓冲器实现JTAG接口电平匹配与隔离。典型型号如SN74LVC1T45(单通道电平移位器,支持1.8V/3.3V电平)在测试接口上用于连接外部调试器与内部核心逻辑之间的电平转换,器件具备低功耗(静态电流仅数微安级)特点,符合低功耗SoC测试设计需求,同时尺寸小、封装灵活适合芯片封装板级开发。
选择该器件的原因在于:支持双向电平转换,适配JTAG各类电压域;功耗低,最大静态电流极小;封装形式简单(SOT-23-6等)便于PCB设计;市场供应稳定,国产替代充足。其主要功能是在测试模式下提供稳定可靠的信号电平桥接,使ATE信号向芯片内部传递无失真。
SWD(Serial Wire Debug)单线调试接口
对于ARM核等设备,建议集成SWD接口作为辅助测试/调试通道。SWD相比传统JTAG引脚更少,节省引脚资源,适合I/O资源紧张的低功耗芯片。SWD的TCK/TMS被替代为SWCLK和SWDIO。
低功耗测试模式下,芯片会通过SWD读取内部寄存器、断点设置、中断状态等信息,便于启动BIST等机制以完成系统级别测试。因此,在设计中应预留SWD引脚,并考虑通过电平移位器如TXB0108(8位双向电平转换)实现不同电压域适配。选择该器件的原因包括:支持自动方向控制、适配多电压体系、支持高速信号,封装多样,适合板级集成。
SPI/I2C测试模式通道
在需要对内部存储器、外设寄存器等进行批量访问的情况下,SPI或I2C可以作为测试通道。建议在低功耗芯片设计中实现测试专用SPI信号路径,该路径仅在测试模式时激活。
为了保证测试过程中SPI信号稳定、无干扰,需选用高性能的缓冲器如74LVC125APWR(四路三态缓冲器),其具备低功耗、宽电压工作能力(1.65V至5.5V)和高隔离性,可以在非测试模式下断开SPI测试链路,避免干扰系统正常运行。
嵌入式BIST逻辑
为了实现芯片内部自测试,自测逻辑应集成在芯片内部,并在特定模式下被激活。推荐在FPGA逻辑块、嵌入式RAM控制器、PLL等核心模块周围加入BIST控制器和结果寄存器。
例如,针对嵌入式SRAM,采用March测试算法的硬件实现以检测存储器短路、开路、 stuck-at故障等。该BIST逻辑在芯片上电测试阶段和ATE测试阶段均可启动。
三、时钟管理与低功耗测试设计
低功耗芯片常采用多电源域和频率可调时钟管理策略,在测试模式下需保证测试逻辑可正常运行,不受低功耗时钟关闭策略影响。
可测试时钟域设计
建议在芯片的时钟树中为测试逻辑单独保留一个低频、可独立供电的时钟源,如32.768kHz低功耗晶振或基于**LSE(Low-Speed External)**时钟。该时钟供测试逻辑、JTAG、SWD等接口使用,以确保即使主PLL、主高速时钟关闭,可测试逻辑仍受控。
选择32.768kHz晶振原因在于其功耗极低、稳定性较好、易于与RTC模块集成,可为测试模式提供稳定时钟基础。
时钟门控与测试模式解耦
在时钟门控单元(Clock Gating)设计中需加入测试模式控制,使时钟门控在测试阶段不会关闭关键信号通路。具体实现可以通过测试模式信号(TEST_MODE)屏蔽时钟门控逻辑,使各模块时钟在测试阶段保持开启。
PLL与时钟锁定测试
芯片内部PLL是时钟生成核心,其锁定状态在测试阶段应可被读取。建议在设计中加入PLL状态寄存器,通过测试接口可读取锁定(LOCK)状态、输入频率、输出频率等信息。
四、电源域划分与低功耗测试策略
低功耗芯片设计通常将不同模块划分在不同电源域,以实现按需供电和休眠策略。然而,电源域切换对可测试性提出挑战。测试逻辑需要处于有效电源域,而其他模块可处于低功耗状态,避免测试失败。
测试供电域设计
建议设置独立的测试供电域(Test Power Domain),其供电可以通过外部测试设备或芯片内部LDO(Low Dropout Regulator)切换。该供电域需包含测试逻辑、测试接口、相关控制寄存器等。因此,即便核心逻辑供电关闭或深度休眠,该域仍能响应测试指令。
电源域隔离控制器
为了避免不同电源域间的信号干扰和浮动,需设计电源域隔离控制器。当某域断电时,隔离器将该域所有输出拉至定义状态(高阻态或预设逻辑电平),避免错误逻辑影响测试结果。
此处推荐使用低功耗隔离逻辑单元如ISO7740(双通道隔离器)实现电源域间信号隔离,其特点是支持宽电压(2.7V至5.5V)、隔离高达数千伏、功耗低并支持高速逻辑信号。选择ISO7740是因为其隔离能力强、可靠性高,适合集成在低功耗SoC电源域隔离设计中。
五、存储单元可测试性设计
嵌入式RAM、ROM、Flash等存储单元为故障敏感区,须具备良好可测试性。
存储器BIST
如前文提及,嵌入式RAM可通过集成BIST逻辑实现自测功能。对于NOR Flash或EEPROM等非易失性存储,测试需验证写入/擦除/读取操作正确性。
针对这些存储单元,可在测试逻辑中加入循环冗余校验(CRC)计算单元,如通过CRC-16/32逻辑单元来验证数据一致性与错误检测。
选择CRC校验逻辑的原因在于其可在低开销下提供强错误检测能力,并通过测试接口可直接读取计算结果,快速定位数据错误。
边界扫描测试(BST)增强
利用JTAG边界扫描链可访问存储器数据总线、地址总线等信号,从而检查存储器接口连通性与信号完整性。结合BST与BIST,可极大提高测试覆盖率。
六、外设模块测试设计与元件选择
低功耗SoC通常集成多种外设,如UART、I2C、SPI、ADC、DAC等。这些模块的可测试性设计同样重要。
UART自动测试单元
UART测试需验证波特率准确性、收发数据正确性。可在设计中加入UART自测试模块(UART ATU),其功能是自动发送测试帧并比较回环结果。
推荐在UART测试逻辑及I/O缓冲器处选用高可靠的电平转移器如MAX3232E(支持RS232<->TTL电平转换且低功耗),用于ATE连接RS232接口测试,理由是该器件支持宽电源电压、低静态电流,并具有自动唤醒功能,符合低功耗设备测试要求。
ADC校准与测试
ADC测试需验证采样精度、线性度、噪声等。建议设计内置可切换参考电压源(如1.2V基准)及测试输入缓冲通路,在ATE模式下输入已知电压值,读取ADC数值比对预期数据。
这里可采用TL431A精密电压基准芯片作为参考电压源,其特点是误差小、温漂低、响应快,适合ADC测试。选择TL431A是因为其稳定的参考电压输出可提高测试精度且易于集成。
DAC测试机制
DAC测试可引入内部回环机制,将DAC输出采样回ADC,通过内置比较逻辑验证输出精度。
七、测试控制逻辑与自动测试设备对接
为了实现与ATE的无缝衔接,可在芯片内部设计统一的测试控制寄存器(Test Control Registers, TCR)和测试状态寄存器(Test Status Registers, TSR)。通过JTAG或SPI测试通道访问这些寄存器,测试系统能够控制测试流程、读取测试结果、触发特定测试序列。
测试流程通常包括以下步骤:
ATE通过测试接口置位TEST_MODE信号;
TCR响应进入测试模式,打开必要测试时钟、电源域;
执行BIST、边界扫描测试、外设测试等,并将结果写入TSR;
ATE读取TSR获取测试结论,并生成测试报表。
因此,在设计中需考虑测试逻辑与正常业务逻辑隔离,避免测试模式影响正常功能。
八、测试数据采集系统与分析策略
对测试数据的采集与分析,建议集成片上诊断单元(On-Chip Diagnostic Unit, OCDU),其作用是收集运行时状态、异常事件、逻辑错误码等,并在测试模式下通过测试接口导出。片上诊断单元可使用易于分析的结构,如环形缓冲器存储错误事件。
数据分析策略包括:
结合BIST结果统计故障率;
通过测试日志分析模块间连接性与时序完整性;
对ADC/DAC精度误差进行统计分析;
自动生成测试矢量覆盖率报告。
九、现场可测试性与在线自检测设计
对于需要长期运行的设备,现场可测试性设计十分重要。建议在SoC中集成在线自检逻辑,当系统空闲或定期触发时执行自测功能,并将结果报告给系统监控单元。
此外,可通过集成状态机、看门狗等机制,在检测到故障时自动进入安全模式,为后续维护提供诊断信息。
十、总结与优化建议
本文从可测试性设计总体目标出发,详细阐述了测试接口设计、时钟与电源域测试策略、存储单元与外设测试设计、测试控制逻辑与数据采集分析等内容。并优选了若干关键元器件型号,如SN74LVC1T45、TXB0108、74LVC125APWR、ISO7740、MAX3232E、TL431A等,讲述其功能及为何在低功耗SoC测试设计中采用该器件的理由。
在实际工程实施过程中,建议设计团队:
在芯片RTL设计初期规划测试接口与BIST模块;
在电源/时钟/逻辑域划分阶段同步考虑可测试性需求;
使用高覆盖率的测试矢量与ATE策略联合提高良率;
在PCB级设计时考虑测试接口布局及信号完整性。
通过上述设计方案与策略,可显著提升低功耗系统芯片的可测试性,实现从研发、生产到现场维护的全生命周期质量保障。各关键元器件均可在拍明芯城www.iczoom.com 查询详细规格、采购信息、国产替代方案及PDF数据手册中文资料,从而支持设计、验证与量产部署全过程。
责任编辑:David
【免责声明】
1、本文内容、数据、图表等来源于网络引用或其他公开资料,版权归属原作者、原发表出处。若版权所有方对本文的引用持有异议,请联系拍明芯城(marketing@iczoom.com),本方将及时处理。
2、本文的引用仅供读者交流学习使用,不涉及商业目的。
3、本文内容仅代表作者观点,拍明芯城不对内容的准确性、可靠性或完整性提供明示或暗示的保证。读者阅读本文后做出的决定或行为,是基于自主意愿和独立判断做出的,请读者明确相关结果。
4、如需转载本方拥有版权的文章,请联系拍明芯城(marketing@iczoom.com)注明“转载原因”。未经允许私自转载拍明芯城将保留追究其法律责任的权利。
拍明芯城拥有对此声明的最终解释权。




 产品分类
产品分类

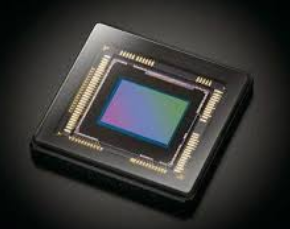






















 2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)
2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)


