基于积累型MOS变容管的射频压控振荡器设计
 14
14
 拍明
拍明
原标题:基于积累型MOS变容管的射频压控振荡器设计
引言
随着移动通信技术的发展,射频(RF)电路的研究引起了广泛的重视。采用标准CMOS工艺实现压控振荡器(VCO),是实现RF CMOS集成收发机的关键。过去的VCO电路大多采用反向偏压的变容二极管作为压控器件,然而在用实际工艺实现电路时,会发现变容二极管的品质因数通常都很小,这将影响到电路的性能。于是,人们便尝试采用其它可以用CMOS工艺实现的器件来代替一般的变容二极管,MOS变容管便应运而生了。
MOS变容管
将MOS晶体管的漏,源和衬底短接便可成为一个简单的MOS电容,其电容值随栅极与衬底之间的电压VBG变化而变化。在PMOS电容中,反型载流子沟道在VBG大于阈值电压时建立,当VBG远远大于阈值电压时,PMOS电容工作在强反型区域。另一方面,在栅电压VG大于衬底电压VB时,PMOS电容工作在积累区,此时栅氧化层与半导体之间的界面电压为正且能使电子可以自由移动。这样,在反型区和积累区的PMOS电容值Cmos等于Cox(氧化层电容)。
在强反型区和积累区之间还有三个工作区域:中反型区,弱反型区和耗尽区。这些工作区域中只有很少的移动载流子,使得Cmos电容值减小(比Cox小),此时的Cmos可以看成Cox和Cb与Ci的并联电容串联构成。Cb表示耗尽区域电容的闭环,而Ci与栅氧化层界面的空穴数量变化量相关。如果Cb(Ci)占主导地位,PMOS器件工作在耗尽(中反型)区;如果两个电容都不占主导地位,PMOS器件工作在弱反型区。Cmos电容值随VBG变化的曲线如图1所示。
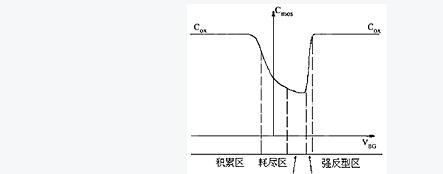
工作在强反型区的PMOS的沟道寄生电阻值可以由下式得出:
(1)

式中,W,L和kp分别是PMOS晶体管的宽度,长度和增益因子。值得注意的是,随着VBG接近阈值电压的,Rmos逐步增加,在VBG等于阈值电压时Rmos为无限大。这个公式基于了简单的PMOS模型,事实上,随着空穴浓度的稳步减少,Rmos在整个中反型区会保持有限值。
反型与积累型MOS变容管
通过上面的分析,我们知道普通MOS变容管调谐特性是非单调的,目前有两种方法可以获得单调的调谐特性。
一种方法是确保晶体管在VG变化范围大的情况下不进入积累区,这可通过将衬底与栅源结断开而与电路中的直流电压短接来完成(例如,电源电压Vdd)。
图2是两个相同尺寸MOS电容的Cmos-VSG特性曲线的相互对比。

很明显反型MOS电容的调谐范围要比普通MOS电容宽,前者只工作在强,中和弱反型区,而从不进入积累区。
更好的方法是应用只工作在耗尽区和积累区的MOS器件,这样会带来更大的调谐范围并且有更低的寄生电阻,即意味着更高的品质因数,原因是其耗尽区和积累区的电子是多子载流子,比空穴的迁移率高约三倍多。要得到一个积累型MOS电容,必须确保强反型区,中反型区和弱反型区被禁止,这就需要抑制任何空穴注入MOS的沟道。方法是将MOS器件中的漏源结的p+掺杂去掉,同时在原来漏源结的位置做n+掺杂的衬底接触,如图3所示。
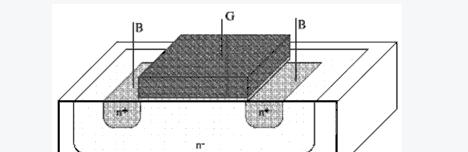
这样就将n阱的寄生电阻减少到。积累型MOS电容和普通MOS电容的调谐曲线如图4所示。
可以看到积累型MOS电容良好的单调性。值得注意的是在设计积累型MOS电容的过程中没有引入任何附加工艺流程。
设计与仿真结果
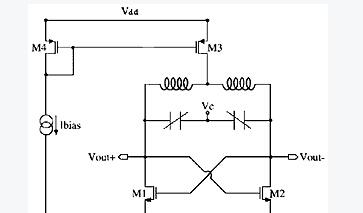
笔者所采用的VCO电路结构如图5所示。这是标准的对称CMOS结构,两个变容管对称连接,减小了两端振荡时电位变化对变容管电容值的影响,提高了频谱纯度。为了保证匹配良好,电感要采用相同的双电感对称连接。此外,由于LC振荡回路由两个尺寸非常大的片内集成电感和两个同样有较大尺寸的积累型MOS变容管组成,较高的损耗使得品质因数不高,这就需要较大的负跨导来维持振荡持续进行;并且等效负跨导的必须比维持等幅振荡时所需要的跨导值大才能保证起振,所以两对耦合晶体管需要设置较大的宽长比,但大的宽长比同时带来较大的寄生效应,造成相位噪声和调谐范围受到影响,终在底端用两个NMOS晶体管形成负电阻以补偿VCO的损耗。根据小信号模型分析,忽略各种寄生及高阶效应,可以估算得到等效负电阻RG的大小为(设两个有源器件跨导分别为gM1,gM2):
(2)

顶端的PMOS晶体管提供偏置电流,这种结构所需的电源电压很低。
整个设计基于TSMC的0.35μm锗硅射频工艺模型PDK,共有三层金属。其中,电感为平面螺旋八边形,由顶层金属绕制而成。选取电感值为0.6nH,那么在振荡频率选定的情况下可以确定总的电容大小。构成LC振荡回路里的电容成份有电感的寄生电容(很小),NMOS晶体管的漏-衬底电容,栅-漏电容,栅-源电容和重要的积累型MOS电容。在保证起振的情况下,为了获得更大的调谐范围,一项所占比例必须尽可能大。

采用的电源电压为1.5V,功耗约为10mW。用Cadence平台下的SpectreRF进行仿真,得到的调谐曲线如图6所示。控制电压在0~2V变化时,振荡频率在3.59~4.77GHz间变化,中心频率为4.18GHz,调谐范围约为28%。中心频率处的相位噪声曲线如图7所示,此时的控制电压为0.75V,对应偏移量600kHz的相位噪声为-128dB/Hz。

当控制电压由0.75V变到2V时,振荡频率变为4.77GHz,相位噪声变为 -135dB/Hz,降低了7dB。这是由两个方面的原因引起的,首先是由于LC振荡回路总的电容减小,振荡频率增加,这就减小了要维持振荡所需的负跨导,但因为两个NMOS晶体管提供的负跨导几乎不变,所以就使得稳定振荡幅度增加,相位噪声减小。另外一方面是源于此过程中积累型MOS电容的沟道寄生电阻会随着电压升高而变小,从而降低了损耗,降低了相位噪声。
与采用反型MOS变容管设计的VCO比较,由于电子具有较高的迁移率,使得积累型MOS电容的沟道寄生电阻比反型MOS电容要低,即意味着积累型MOS电容具有较高的品质因数,导致了VCO整体性能有所提高,特别是相位噪声有所减少。比较结果如表1所示。考虑到工艺和功耗等因素,采用积累型MOS电容有更大的优势。

结论
基于0.35μm工艺,考虑低压和低功耗,设计了一个工作频率为4.2GHz的VCO,并在该电路中分别采用积累型MOS电容和反型MOS电容进行调谐。仿真结果表明,两种VCO调谐范围与中心频率几乎相同,在功耗约为10mW的情况下,积累型MOS调谐的VCO表现出更好的相位噪声性能。
责任编辑:
【免责声明】
1、本文内容、数据、图表等来源于网络引用或其他公开资料,版权归属原作者、原发表出处。若版权所有方对本文的引用持有异议,请联系拍明芯城(marketing@iczoom.com),本方将及时处理。
2、本文的引用仅供读者交流学习使用,不涉及商业目的。
3、本文内容仅代表作者观点,拍明芯城不对内容的准确性、可靠性或完整性提供明示或暗示的保证。读者阅读本文后做出的决定或行为,是基于自主意愿和独立判断做出的,请读者明确相关结果。
4、如需转载本方拥有版权的文章,请联系拍明芯城(marketing@iczoom.com)注明“转载原因”。未经允许私自转载拍明芯城将保留追究其法律责任的权利。
拍明芯城拥有对此声明的最终解释权。




 产品分类
产品分类
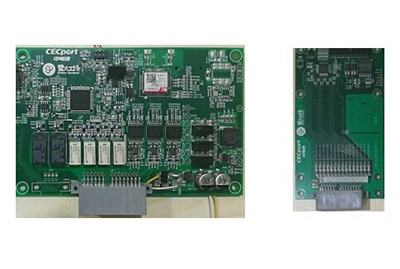


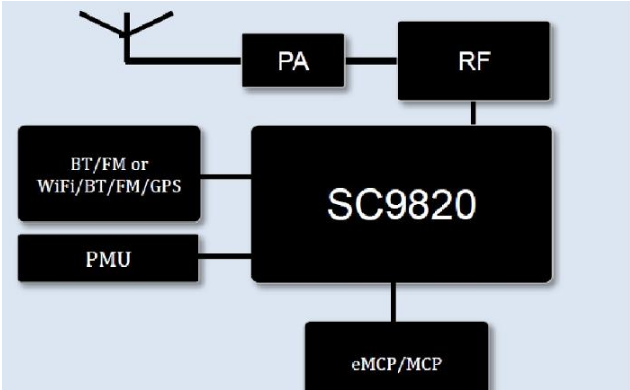











 2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)
2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)


