基于设计数据共享的板级热仿真技术研究(二)
 55
55
 拍明
拍明
原标题:基于设计数据共享的板级热仿真技术研究(二)
3 叠层铜分布影响研究
系统级热仿真中各种不同板卡的PCB 板往往使用单一薄板模型替代,且赋予单一的热物性参数.而实际情 况是多层PCB 板各叠层以及每层不同区域的铜分布不均匀,传热能力差异明显.在某些情况下,此差异可能会使系统热仿真结果产生很大偏差.因此,需要对 PCB 板各叠层的铜分布进行详细建模与仿真分析.
3. 1 叠层建模对比分析
3. 1. 1 算例描述
以 下通过一个简化算例对比PCB 叠层详细建模与简单建模造成的偏差.以某产品板卡为例进行简化,分别对板卡叠层进行简单建模和复杂建模,对比各个芯片温度 差异.其中边界条件和网格设定均一致,边界条件为开放环境,水平风速为2 m/s.简单模型PCB 设定的3 个方向的导热系数为 Kx = Ky = 40 W/( m·K) ,Kz = 5 W/( m·K)( 简称SIMPLE 40_40_5).详细模型PCB 使用软件设定 参数RLS =50 和NCB =256 进行自动划分,且对各个区域进行自动特性参数赋值( 简称PCB 50_256).图4 为该产品板卡的热仿真 模型.

3. 1. 2 仿真结果及其分析
仿真温度结果对比见表1 和图5.


从上面的对比来看,以往根据经验设定的简单模型PCB 设定物性参数为Kx = Ky = 40,Kz = 5,与实际详细PCB 计算结果差异很明显,一般都有6 ℃ ~39 ℃的偏差.
一 个需要注意的细节是各个芯片计算结果误差的变化范围较大,其中D7 的误差仅为0. 7 ℃,而D29 的误差为39 ℃.这是因为在此模型中D7 表面 使用了散热片,而其他芯片表面没有散热片.没有使用散热片的芯片( 如D29) 的散热途径主要是通过PCB 板导热,然后再由PCB 板表面的空气对流 带走热量,所以PCB 板的建模对其结果影响非常明显.
而D7 由于表面使用了散热片,主要的散热途径是通过芯片表面将热量传导到散热片,通过散热片表面的空气对流带走热量,所以相对来说PCB 的建模对其结果影响较小.
3. 2 叠层铜分布建模优化
3. 2. 1 问题描述
根据目前的使用经验,PCB 叠层划分过于精细将带来下面2 个问题:
1) 网 格数量与质量.以某产品板卡为例,如果按照RLS = 50 和NCB = 256 对每层进行平面划分,且每层至少有一层网格进行描述,则单板 PCB 部分的网格数量将近数十万.由于每层的厚度与板卡长宽相差几个数量级,所以每层的厚度不要使网格的横纵比大于250,以免造成较差的网格质量.
2) 模 型块的数量.如果RLS = 50,NCB = 256,则某产品板卡的PCB 需要由16 000 个不同物性参数的模型块拼成.数量巨大的模型块无论 是在建模.计算还是后处理过程中都会占用大量的系统内存和显存,使部分配置不高的计算机工作效率很低,甚至无法进行.因此为了在保证计算精度的前提下提高 计算效率,需对建模的精细化程度进行优化研究.
3. 2. 2 算例描述
以前述算例为基准,设定RLS =50 或30,NCB =256或9.2 个参数分别取2 个值进行搭配,得到4 个算例: PCB 50_256,PCB 50_9,PCB 30_256 和PCB 30_9.
3. 2. 3 仿真结果及其分析
不同叠层划分精度的仿真温度对比见表2 和图6.


从仿真结果可以看出: 当RLS 从50 降至30,NCB从256 降至9 时,此模型的散热仿真结果误差较小,在保证一定精度的前提下能有效减少模块数量,提高计算效率.使用RLS = 30 和NCB = 9,既能保证一定的计算精度,也能保证计算效率.
3. 3 板级与系统级联合热仿真
3. 3. 1 算例描述
为 了进一步验证此简化方法,在某插箱产品的系统级模型中,选择散热状况恶劣的槽位对某产品板卡使用PCB 叠层详细模型,分别带入 PCB 50_256 和PCB 30_9 进行计算.同时设定PCB 简化模型,分别设定不同的物性参数 SIMPLE 40_40_5: Kx = Ky = 40,Kz = 5; SIMPLE7_7_1: Kx = Ky =7,Kz =1.
3. 3. 2 仿真结果及其分析
板级与系统级联合热仿真结果如图7 所示.
从联合热仿真结果可知,PCB 50_256 和PCB 30_9的计算结果很接近.在实际使用过程中可以使用RLS = 30 和NCB = 9,这样既能保证一定的计算精度,也能保证计算效率.
之 前使用的简化PCB 物性参数经验设定与实际情况差异较大,但根据调试,当设定Kx = Ky = 7,Kz = 1时,与详细PCB 模型计算结果也很 相近,如果继续优化,也应该能与详细模型计算达到较好的吻合.但是这个简化设定会因实际PCB 设计不同和散热方式( 自然对流或强迫对流) 不同而改变.

4 过孔影响研究
根 据之前的板级热设计研究的经验,板卡芯片的散热主要分为2 类: 使用散热片或以主动散热为主的芯片,不使用散热片或以被动散热为主的芯片.对于后一类, 散热的主要途径主要是热传导,大部分热量通过芯片往下传导到PCB 板上,然后从PCB 板向水平方向扩散到较大的面积,并通过PCB 板的上下表面与空 气进行对流换热.在此过程中,热量首先从芯片通过热过孔向下传导到PCB 内部,然后才是PCB 内部的导热.所以要保证板级热仿真的精度,不仅需要对 PCB板内部各叠层的铜分布进行详细建模,还需要对热过孔的建模进行研究.
4. 1 热过孔建模影响分析
对某产品板 卡进行简化,仅仅留下功耗1 W 以上的主要芯片,分别对板卡进行简单建模和复杂建模,对比各个芯片温度差异.其中边界条件和网格设定均一致,边界条件为 开放环境,水平风速为2 m/s.详细模型PCB 使用软件设定参数RLS = 30,NCB = 9 进行自动划分,且对各个区域自动进行特性参数的赋 值.热过孔详细建模如图8 所示,各个芯片的功耗见表3.

选 取D33.D7.MOS1.L1 和MOS2 共5 个芯片,在各个芯片下面建立一定数量的热过孔,热过孔截面大小假定为 0. 5 mm × 0. 5 mm.分别对5 芯片全带热过孔( All) .删除D7 热过孔( NoD7) .删除D33 热过孔 ( NoD33) 和删除MOS 热过孔( NoMOS) 4 种情况进行计算,计算结果见表4.对比有无热过孔对芯片本身及其邻近芯片散热的影响,如图 9 所示.

从 上面的结果来看,对于使用散热片的D7,建立热过孔与否对计算结果影响不大.但对于不使用散热片的D33 以及MOS 等芯片,建立热过孔与否对计算结果 影响明显.其原因与前面提到的相同,即不使用散热片进行被动散热的芯片,其大部分热量需要导入PCB 进行散热,因为增加热过孔与否对热量传导到 PCB 上的影响明显,因而也明显影响到了芯片的温度计算结果.表5 列出了2 个芯片通过底部传到PCB内的热量占总热量的百分比和受热过孔的影响程 度,该表进一步验证了上面的分析

4. 2 热过孔建模简化
实际的热过孔几何尺寸相对较小,受网格数量和计算机计算能力的限制,在板卡级别以及系统级别的散热仿真中不可能对其进行详细的建模,因此,有必要在保证一定精度的前提下,寻找简化的建模方法.
基 本的简化思路是计算每个热过孔的截面积以及过孔数量,按照截面积相等的原则,简化为1 个或几个大的热过孔.这样能保证替代物与详细模型有相等的截面积和 体积.但是需要考虑的是,热过孔是通过其侧面与PCB 中各层的接触进行导热的,在截面积和体积相同时,孔数量越多侧面积越大,所以过于粗略的简化,会使 侧面积过小.按照截面积相等的原则,分别把热过孔简化为1 个.2 个.4 个大过孔,如图10 所示.
简化后的芯片温度对比见表6.

从表6 可以看出,使用4 个大过孔替代后的简化模型与详细模型的计算差别在1. 2 ℃左右,相当于芯片温升的3%左右,属于可以接受的误差范围.
5 结 束语1) 基于设计数据共享的板级建模对于准确分析预测板级以及芯片级散热是必要和有效的;2) 考虑叠层铜分布的PCB 详细建模需要对计算精度和效率 进行平衡;3) 热过孔对于板级热仿真结果的精度影响明显,直接影响到每个芯片尤其是不使用散热片的芯片的散热;4) 热过孔可以通过截面积相等的原则进 行简化,但不宜过粗.
基于设计数据共享的板卡建模技术研究分析表明,兼顾仿真精度与计算效率的板级热仿真技术可以较地预测芯片的结温和壳温,为系统级热仿真提供更为准确的局部环境.
责任编辑:
【免责声明】
1、本文内容、数据、图表等来源于网络引用或其他公开资料,版权归属原作者、原发表出处。若版权所有方对本文的引用持有异议,请联系拍明芯城(marketing@iczoom.com),本方将及时处理。
2、本文的引用仅供读者交流学习使用,不涉及商业目的。
3、本文内容仅代表作者观点,拍明芯城不对内容的准确性、可靠性或完整性提供明示或暗示的保证。读者阅读本文后做出的决定或行为,是基于自主意愿和独立判断做出的,请读者明确相关结果。
4、如需转载本方拥有版权的文章,请联系拍明芯城(marketing@iczoom.com)注明“转载原因”。未经允许私自转载拍明芯城将保留追究其法律责任的权利。
拍明芯城拥有对此声明的最终解释权。




 产品分类
产品分类
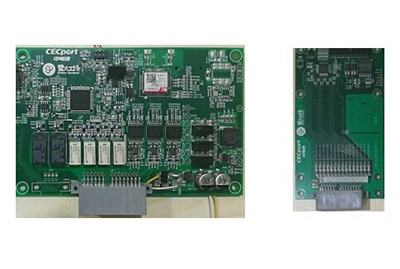


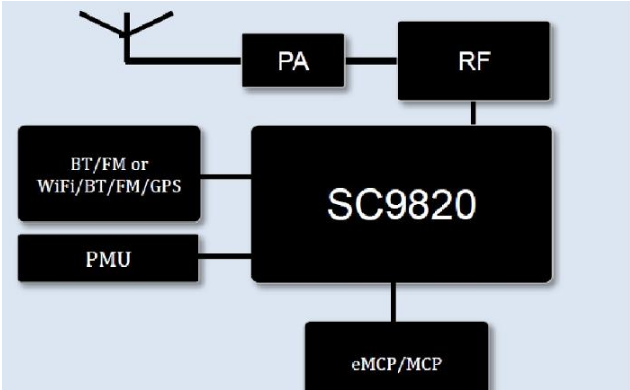











 2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)
2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)


