传台积电已将2.5D封装技术CoWoS部分流程外包给OSAT
 14
14
 拍明
拍明
原标题:传台积电已将2.5D封装技术CoWoS部分流程外包给OSAT
关于台积电将2.5D封装技术CoWoS(Chip On Wafer On Substrate)部分流程外包给OSAT(外包半导体封装和测试)厂商的传闻,确实有一定的依据。以下是基于相关报道和信息的详细解答:
一、传闻背景
时间:这一传闻最早在2021年11月26日被台湾《电子时报》报道,并随后被多家媒体转载。
内容:台积电已将2.5D封装技术CoWoS封装业务的部分流程外包给日月光(ASE)、矽品、安靠(Amkor)等OSAT厂商。
二、具体流程
CoWoS技术概述:CoWoS技术是一种先进的封装技术,它先将芯片通过Chip on Wafer(CoW)的封装制程连接至硅晶圆,再把CoW芯片与基板连接(oS)。这种技术可以显著提高芯片的集成度和性能。
外包流程:在CoWoS封装流程中,台积电主要在晶圆层面处理CoW流程,即将芯片连接到硅晶圆上。而oS(On Substrate)流程,即将CoW芯片与基板连接的部分,则被外包给了日月光、矽品、安靠等OSAT厂商。这是因为oS流程中无法实现自动化的部分较多,需要更多的人力投入,而这些OSAT厂商在oS流程处理方面拥有丰富的经验和更强的能力。
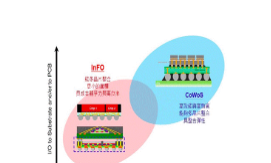
三、合作原因与预期
原因:台积电选择将部分封装流程外包给OSAT厂商,主要是出于成本效益和灵活性的考虑。通过外包,台积电可以专注于自己更擅长的晶圆制造环节,同时利用OSAT厂商的专业能力来优化封装流程,提高整体效率和产品质量。
预期:类似的合作模式预计将在未来的3D IC封装中继续存在。随着异构芯片集成需求的显著增长,台积电可能会采用更灵活的模式与OSATs合作,以满足市场不断变化的需求。
四、其他相关信息
台积电封装业务概况:在封装业务方面,台积电最赚钱的是晶圆级SiP技术,如CoW和WoW(Wafer-on-Wafer),其次是FOWLP(Fan-Out Wafer-Level Packaging)和InFO(Integrated Fan-Out)技术。而oS流程的利润相对较低。
台积电与苹果的合作:台积电还采用无基板的Infou PoP技术,对采用先进工艺节点制造的iPhone APs(应用处理器)进行封装。这种强大的集成制造服务有助于台积电从苹果等大客户那里获得大量订单。
综上所述,台积电将2.5D封装技术CoWoS部分流程外包给OSAT厂商是出于多方面的考虑和市场需求。这种合作模式不仅有助于提升台积电的整体效率和产品质量,还为其在封装领域的进一步发展奠定了基础。
责任编辑:David
【免责声明】
1、本文内容、数据、图表等来源于网络引用或其他公开资料,版权归属原作者、原发表出处。若版权所有方对本文的引用持有异议,请联系拍明芯城(marketing@iczoom.com),本方将及时处理。
2、本文的引用仅供读者交流学习使用,不涉及商业目的。
3、本文内容仅代表作者观点,拍明芯城不对内容的准确性、可靠性或完整性提供明示或暗示的保证。读者阅读本文后做出的决定或行为,是基于自主意愿和独立判断做出的,请读者明确相关结果。
4、如需转载本方拥有版权的文章,请联系拍明芯城(marketing@iczoom.com)注明“转载原因”。未经允许私自转载拍明芯城将保留追究其法律责任的权利。
拍明芯城拥有对此声明的最终解释权。




 产品分类
产品分类























 2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)
2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)


