三星宣布正式推出全新 2.5D 封装解决方案 H-Cube
 10
10
 拍明
拍明
原标题:三星宣布正式推出全新 2.5D 封装解决方案 H-Cube
三星宣布正式推出的全新2.5D封装解决方案H-Cube(Hybrid Substrate Cube,混合基板封装)是针对高性能计算(HPC)、人工智能(AI)、数据中心和网络产品等需要高性能和大面积封装技术的领域而设计的。以下是对该解决方案的详细解析:
一、技术背景
随着现代高性能计算、人工智能和网络处理芯片的规格要求越来越高,需要封装在一起的芯片数量和面积剧增,带宽需求也日益增高。这使得大尺寸的封装变得越来越重要,但同时也带来了制造上的挑战。三星推出的H-Cube封装解决方案正是为了应对这些挑战而开发的。
二、技术特点
混合基板设计:
H-Cube封装解决方案通过整合两种具有不同特点的基板,即精细化的ABF(Ajinomoto Build-up Film,味之素堆积膜)基板和高密度互连(HDI)基板,实现了更大的2.5D封装。这种混合基板设计能够有效地解决大面积基板制造难度高、生产效率低的问题。
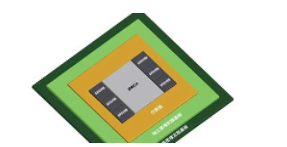
缩小基板尺寸:
三星通过将连接芯片和基板的焊锡球间距缩短35%,成功地缩小了ABF基板的尺寸。同时,在ABF基板下添加HDI基板以确保与系统板的连接,从而实现了更紧凑的封装结构。
稳定供电和信号传输:
三星应用了其专有的信号/电源完整性分析技术,在堆叠多个逻辑芯片和高带宽内存(HBM)时,能够稳定地提供电源,并最大限度地减少信号损失或失真。这确保了H-Cube封装解决方案在高性能应用中的可靠性和稳定性。
三、合作与开发
H-Cube封装解决方案是三星与三星电机(SEMCO)以及主要的OSAT(组装和最终检查承包商)Amkor Technology联合开发的。这种跨公司的合作模式有助于整合各方资源和技术优势,共同推动2.5D封装技术的发展和应用。
四、市场前景
随着高性能计算、人工智能和网络市场的不断扩展,对高性能和大面积封装技术的需求将持续增长。三星的H-Cube封装解决方案凭借其先进的技术特点和广泛的应用前景,有望在这些领域占据重要地位。同时,随着技术的不断成熟和成本的降低,H-Cube封装解决方案的市场竞争力也将进一步增强。
综上所述,三星宣布正式推出的全新2.5D封装解决方案H-Cube是一项具有创新性和前瞻性的技术成果。它不仅解决了当前高性能计算、人工智能和网络产品领域面临的封装挑战,还为未来的技术发展奠定了坚实的基础。
责任编辑:David
【免责声明】
1、本文内容、数据、图表等来源于网络引用或其他公开资料,版权归属原作者、原发表出处。若版权所有方对本文的引用持有异议,请联系拍明芯城(marketing@iczoom.com),本方将及时处理。
2、本文的引用仅供读者交流学习使用,不涉及商业目的。
3、本文内容仅代表作者观点,拍明芯城不对内容的准确性、可靠性或完整性提供明示或暗示的保证。读者阅读本文后做出的决定或行为,是基于自主意愿和独立判断做出的,请读者明确相关结果。
4、如需转载本方拥有版权的文章,请联系拍明芯城(marketing@iczoom.com)注明“转载原因”。未经允许私自转载拍明芯城将保留追究其法律责任的权利。
拍明芯城拥有对此声明的最终解释权。




 产品分类
产品分类
























 2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)
2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)


