宜特晶圆减薄能力达1.5mil
 123
123
 拍明
拍明
原标题:宜特晶圆减薄能力达1.5mil
宜特(iST)的晶圆减薄能力确实达到了1.5mil(38um)。以下是对此能力的详细解释:
一、技术突破
宜特晶圆后端工艺厂(竹科二厂)成功开发了晶圆减薄达1.5mil的技术,并通过了客户的肯定。这一技术门槛的突破,显示了宜特在晶圆减薄领域的先进实力。
二、技术优势
高精度:宜特已完成从2mil(50um)到1.5mil(38um),甚至到0.4mil(10um)的减薄技术开发。这种高精度的减薄能力,使得晶圆在保持足够强度的同时,能够进一步减小封装体积,提高芯片的散热效率和性能。
高强度:在减薄过程中,宜特采用特殊的优化工艺,能够兼顾晶圆强度,避免破片率居高不下的风险。通过蚀刻工艺优化和专业的芯片强度测试,宜特确保了减薄后的晶圆仍具有足够的强度和可靠性。
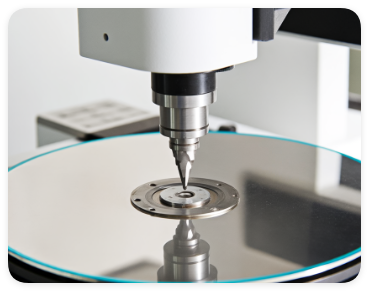
三、应用领域
宜特的晶圆减薄技术广泛应用于功率半导体领域。功率半导体进行“减薄”,是改善工艺、实现“低功耗、低输入阻抗”最直接有效的方式。晶圆减薄不仅有助于减少后续封装材料体积,还能降低RDS(on)(导通阻抗),进而减少热能累积效应,增加芯片的使用寿命。
四、公司背景
宜特(iST)自1994年创立以来,从IC线路除错及修改起家,逐年拓展新服务,包括失效分析、可靠性验证、材料分析等。目前,宜特已建构完整的验证与分析工程平台与全方位服务,客群囊括电子产业上游IC设计至中下游成品端。此外,宜特还建置了车用电子验证平台、高速传输信号测试等服务,秉持着提供客户完整解决方案的宗旨,从验证领域跨入“晶圆后端工艺整合”量产服务。
综上所述,宜特的晶圆减薄能力达到了1.5mil,并凭借高精度、高强度和广泛的应用领域等优势,在功率半导体领域展现了强大的竞争力。
责任编辑:
【免责声明】
1、本文内容、数据、图表等来源于网络引用或其他公开资料,版权归属原作者、原发表出处。若版权所有方对本文的引用持有异议,请联系拍明芯城(marketing@iczoom.com),本方将及时处理。
2、本文的引用仅供读者交流学习使用,不涉及商业目的。
3、本文内容仅代表作者观点,拍明芯城不对内容的准确性、可靠性或完整性提供明示或暗示的保证。读者阅读本文后做出的决定或行为,是基于自主意愿和独立判断做出的,请读者明确相关结果。
4、如需转载本方拥有版权的文章,请联系拍明芯城(marketing@iczoom.com)注明“转载原因”。未经允许私自转载拍明芯城将保留追究其法律责任的权利。
拍明芯城拥有对此声明的最终解释权。




 产品分类
产品分类

























 2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)
2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)


