sip系统级封装技术优势及设计流程
 854
854
 拍明
拍明
l SiP系统级封装技术优势
SiP(System in Package)系统级封装技术正成为当前电子技术发展的热点,受到了来自多方面的关注,这些关注既来源于传统封装 Package 设计者,也来源于传统的 MCM 设计者,更多来源于传统的 PCB 设计者,甚至 SoC 的设计者也开始关注SiP。
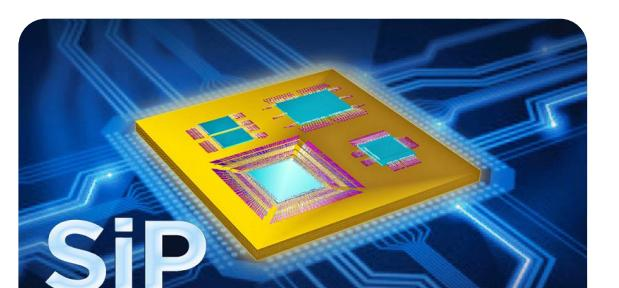
和 Package 比较而言,SiP 是系统级的多芯片封装,能够完成独立的系统功能。和 MCM 比较而言,SiP 是 3D 立体化的多芯片封装,其 3D 主要体现在芯片堆叠和基板腔体上,同时,SiP 的规模和所能完成的功能也比 MCM 有较大提升。
和 PCB 比较而言,SiP 技术的优势主要体现在小型化、低功耗、高性能方面。实现和 PCB 同样的功能,SiP 只需要 PCB 面积的 10-20%左右,功耗的 40%左右,性能也会有比较大的提升。
和 SoC 比较而言,SiP 技术的优势主要体现在周期短、成本低、易成功方面。实现同样的功能,SiP 只需要 SoC 研发时间的 10-20%,成本的 10-15%左右,并且更容易取得成功。
因此,SiP 被很多行业用户作为 SOC 建设的低成本、短期替代方案,SOC 项目开始时以 SiP 作为先行者,迅速且低成本地做出 SiP 产品,当 SiP 在项目上取得一定的阶段性成果之后,收到多方认可和支持,再将重心转到 SOC 研发上。·
对于航天应用中的抗辐照设计,国内外已经开始考虑在 SiP 封装外壳材料上进行抗辐照加固处理,这样比在板级加固效果要更好,而且重量更轻,更利于航天应用。
SiP 和 PCB 相比,由于面积更小,互联线更短,所以其高频特性更好。同时,由于互联线短,消耗在传输线的能量更少,从而也在一定程度上节省了功耗,实现了降低功耗的作用,在高速电路设计中这种效果尤其明显。
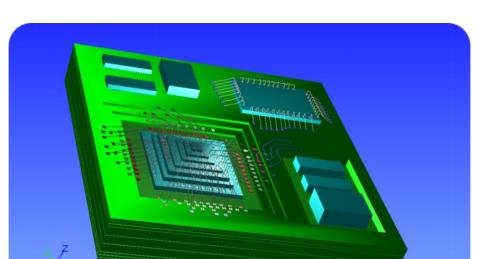
SiP是IC产业链中知识、技术和方法相互交融渗透及综合应用的结晶,它最大限度地灵活应用各种不同芯片资源和封装互连优势。
SiP 系统级封装集成能最大程度上优化系统性能,避免重复封装,缩短开发周期、降低成本并提高集成度,掌握这项新技术是进入主流封装领域之关键。
在国际上,SiP 技术被广泛应用于航空航天、军工、无线通信、传感器、计算机和网络等方面。
目前全世界封装产值只占 IC 总产值的 10%左右,当 SiP 技术被封装企业掌握后,产业格局就要开始调整,封装行业将会出现一个跳跃式的发展,这是中国发展具有 IP 核的大好时机。毋须置疑,SiP 技术不仅面临着更大的机遇和挑战,而且也孕育着更为广阔的发展空间。
SiP 技术是近些年来国内外研究的重点,是电子系统小型化的重要手段,SiP 可以通过传统的微组装技术来实现 3D 系统级封装,表现为芯片堆叠、封装堆叠及基板堆叠等方式来实现,另一种方式是通过硅通孔技术(TSV)实现系统级封装。
在国内,越来越多的电子设计工程师开始关注和学习 SiP 的技术,但由于目前关于
SiP 设计和仿真方面的综合书籍很缺乏,设计者往往无从下手,这在一定程度上也阻碍了 SiP 技术在国内的快速发展。
Mentor Xpedition 是一款专业的 SiP 设计工具,包括原理图设计、版图布线设计、电学分析及热分析等模块,可以实现芯片堆叠、基板堆叠、复杂腔体结构设计,是一款真正意义上的 3D 设计工具。

基于 Xpedition (Expedition)的 SiP 的高级设计指南技术书籍《SiP 系统级封装设计与仿真》
2012 年由电子工业出版社正式出版发行,大大地便利了关注和学习 SiP 技术的工程技术人员。
在该书的基础上,2017 年 7 月,由 WILEY 在全球出版并发行了英文版技术书籍《SiP System-in-Package
Design and Simulation Mentor EE Flow Advanced DesignGuide》,目前在亚马逊网站已经有售。

l SiP 设计与仿真流程的主要内容
SiP的设计与仿真流程的主要内容如下图所示:

(1)设计准备
设计准备的工作主要包括:① 各种资料的收集,裸芯片相关资料,管脚定义,物理尺寸,能否采购获取等。② 封装类型的确定,是采用 BGA 封装还是其他封装形式;封装尺寸的确定;封装管脚间距、管脚数目的确定。③ 采用自定义管脚排列方式还是采用标准的封装,或者和别人曾经用过的封装管脚兼容,以便于后期的组装和测试。④ 封装工
艺和材料的选择,根据其应用的领域选择塑封、陶瓷封装或者金属封装。
(2)建库及库管理
建库及库管理主要包括原理图符号库、IC 裸芯片库、BGA 封装库、Part 库以及仿真模型库等。
(3)原理图设计
原理图设计包括原理图输入,射频原理图设计以及原理图协同设计等。
(4)设计前仿真
设计前仿真可和原理图设计同步进行,通过“What if”分析,确定设计层叠结构、关键信号的网络拓扑结构、阻抗匹配,以及电源平面的分割、电容种类及型号选择等。对模拟电路或者数模混合电路,可进行电路的功能仿真。
(5)工艺选择
工艺选择主要是为了确定 SiP 采用哪种工艺的封装形式,如 Wire Bonding、FlipChip、TAB、TSV 等。基板上是否要挖腔体,采用单面腔体还是基板顶层/底层双面腔体,以及腔体的深度等,同时也要考虑是否要做芯片堆叠 Stacked Dies,基板的层数和需要采用的层叠结构等通常在这一步也要定下来。
(6)进入版图设计环境
通过打包 Package 功能,以及前向标注等手段将原理图的连接关系、规则定义等传输到版图环境,同时自动调用中心库的相关 Cell 放到版图设计环境中。
(7)层叠设置
根据工艺的选择及设计的复杂程度进行层叠结构的设置,包括层数以及层叠结构的选
择,是采用 1+N+1、2+N+2、m+N+m 或者 ALIVH 等层叠结构。
(8)约束规则设置
主要包括网络分类,结构约束规则、间距约束规则、电气约束规则,高速网络约束、
差分对约束等。
(9)器件布局
主要确定裸芯片的摆放位置。如果芯片需要放置到腔体里,则需要确定腔体的深度以及是单级还是多级腔体,腔体形状的绘制等。
(10)引线键合、布线和敷铜
主要确定键合线的键合方式,是单层键合线还是多层键合线,键合线的模型选择,电源环的设置;选择交互式手工布线或自动布线,电源平面层分割,射频电路设计,埋阻埋容的自动综合等。这一步工作量比较大。
(11)版图设计检查
通过检查可发现版图设计中的 DRC 错误并进行修正,确保设计功能的正确性。
(12)设计后仿真
设计后仿真可通过专用接口导出到仿真工具,进行信号完整性、电源完整性及电磁兼容方面的仿真和分析。
(13)设计热分析
可通过专用接口导入热分析工具。通过热分析,可解决 SiP 工作中由于芯片功耗过大而发生的过热问题,确保产品的稳定性和可靠性。
(14)后处理及生产文件
包括 Gerber 及钻孔文件的生成,BOM、DXF、IDF、GDSII、ODB++等格式的输出。
(15)电子结构一体化设计
电子结构一体化主要包括电子和结构的协同。因为 EDA 工具主要完成的是 SiP 内部的东西,包括基板和芯片组装、键合等。而 SiP 的外壳等数据通常需要通过结构设计软件来确定,如陶瓷封装的金属框架、盖板、塑封的模封,金属封装的外壳等。
(16)设计结束
所有上面的流程走完之后,SiP 设计结束,即可进入生产阶段。
资讯下载
责任编辑:Davia
【免责声明】
1、本文内容、数据、图表等来源于网络引用或其他公开资料,版权归属原作者、原发表出处。若版权所有方对本文的引用持有异议,请联系拍明芯城(marketing@iczoom.com),本方将及时处理。
2、本文的引用仅供读者交流学习使用,不涉及商业目的。
3、本文内容仅代表作者观点,拍明芯城不对内容的准确性、可靠性或完整性提供明示或暗示的保证。读者阅读本文后做出的决定或行为,是基于自主意愿和独立判断做出的,请读者明确相关结果。
4、如需转载本方拥有版权的文章,请联系拍明芯城(marketing@iczoom.com)注明“转载原因”。未经允许私自转载拍明芯城将保留追究其法律责任的权利。
拍明芯城拥有对此声明的最终解释权。




 产品分类
产品分类















 2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)
2012- 2022 拍明芯城ICZOOM.com 版权所有 客服热线:400-693-8369 (9:00-18:00)


